|
Desde
el punto de vista experimental, la capacitancia diferencial
vs el voltaje aplicado, es una técnica alternativa
para el estudio de las propiedades eléctricas de
los dispositivos semiconductores. Estas mediciones están
basadas en la relación lineal entre C-2
y el voltaje, la cual permite determinar la concentración
de carga y la altura de la barrera de Schottky.
Este
artículo tiene como objetivo principal presentar
los resultados obtenidos del cálculo de la capacitancia
diferencial para dos transistores de efecto de campo, con
dopaje tipo delta en una y dos capas atómicas en
una matriz de GaAs, el d-FET
(Schubert y Ploog, 1985)1
y el ALD-FET (Yamaguchi,
et
al., 1982)2
, respectivamente. Para hacer esto usamos un par de modelos
sencillos que describen el perfil de la banda de conducción
del semiconductor de cada uno de ellos y hacemos una simulación
numérica de las curvas de la capacitancia diferencial
a la menos dos contra el voltaje de contacto. Estos modelos
han demostrado reproducir con muy buena precisión
otras características electrónicas de estos
dispositivos, como son los niveles de energía, ya
que se han comparado los resultados obtenidos con estos
modelos, con los emanados autoconsistentemente (Gaggero
y Mora, 1997),3
pero por ahora sólo calculamos la capacitancia diferencial.
La principal motivación para el estudio de la capacitancia
diferencia y en general las propiedades electrónicas
de estos sistemas, es que ellos poseen propiedades que permiten
su utilización en aplicaciones que requieren alta
velocidad de respuesta, así como una movilidad de
portadores de carga más grande que la que ofrecen
los FET convencionales.
¿Qué
son los Transistores Efecto de Campo?
Un
transistor efecto de campo (FET por sus siglas en inglés)
es un dispositivo electrónico de tres terminales,
las cuales reciben los nombres de fuente, compuerta y drenaje.
Este tipo de dispositivos semiconductores tiene muchas aplicaciones
en la industria electrónica. Los podemos encontrar
prácticamente en cualquier dispositivo, desde un
reproductor de CD portátil, un televisor o una computadora,
entre otros.
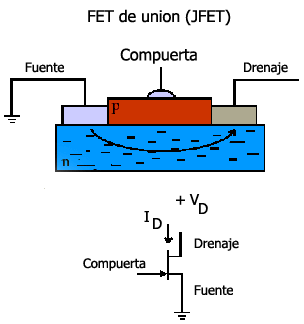
Figura 1. Representación esquemática
de un JFET
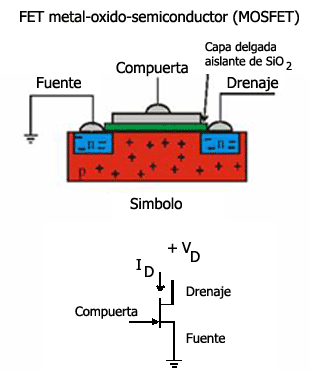
Figura 2. Representación esquemática
de un MOSFET
Los
FET pueden construirse como un FET de unión (JFET),
o como un FET metal-óxido-semiconductor (MOSFET).
En las figuras 1 y 2presentamos un par de diagramas
sobre cuál es la estructura de estos dispositivos
(Millman
y Grabel, 1987)2.
Hoy en día existen una gran cantidad de dispositivos
semiconductores que han permitido muchas innovaciones tecnológicas,
las cuales implican cada día más y mejores
tecnologías a nuestro alcance. Es por eso que han
tenido mucho auge en los últimos años y lo
seguirán teniendo gracias a la invención de
nuevos materiales y dispositivos (Kwok,
1996)
(San,et
al., 1998).
Una
de las características principales de los transistores
efecto de campo es que el flujo de portadores mayoritarios
a lo largo del canal de conducción, es controlado
principalmente por el voltaje aplicado a la compuerta, que
de ahora en adelante lo denominaremos voltaje de contacto
Vc. Dicho voltaje
produce una región de empobrecimiento de portadores
de ancho lp . La compuerta está
constituida por un contacto metal-semiconductor (suponemos
que no existe capa alguna de óxido como se muestra
en la figura 2), que produce una barrera de potencial
conocida como barrera de Schottky. Esta se debe a la diferencia
en las funciones de trabajo del metal y del semiconductor.
La función de trabajo se define como la energía
necesaria para extraer un electrón, desde el nivel
de Fermi hasta el nivel de vacío, es decir, cuando
el electrón se encuentra suficientemente lejos de
la superficie para no sentir la interacción de los
electrones de ésta, y suficientemente cerca como
para considerar infinita dicha superficie. En los semiconductores
no existen electrones en el nivel de Fermi, pero la definición
se hace válida porque esto sólo es un promedio
estadístico. La definición del nivel de Fermi,
o energía de Fermi, es el último nivel de
energía ocupado por los electrones en el material
a 0o K. En realidad este concepto no es trivial
y si alguien está interesado en una definición
específica y más completa, puede leer algo
más acerca del tema en las referencias al final del
artículo (Ashcroft
e I. Mermin, 1976).
La
región de empobrecimiento en una barrera de Schottky
la podemos considerar en algunos aspectos como un capacitor
de placas paralelas, cuya separación estaría
dada por el ancho de la región de empobrecimiento
lp. En este caso es al mismo tiempo
la longitud de penetración del campo eléctrico
dentro del semiconductor, es decir, la longitud de Debye.
La capacitancia diferencial por unidad de área, está
definida por (Rhoderick
y Williams, 1988):

(Ecuación
1)
donde
Qd = -e Ndlp
es la carga debida a los donadores en la región de
empobrecimiento. Entonces encontramos que (Martínez,
1999):

(Ecuación
2)
En
este trabajo lo que nos interesa es la variación
de lp con Vc, es decir,
la capacitancia diferencial. Para un sistema dado, a una
temperatura fija, esta variación depende de la diferencia
de potencial aplicada a la compuerta. La forma más
usual de presentar los resultados obtenidos de la capacitancia
diferencial es C-2, como función del voltaje
de contacto Vc, la que para este caso,
en que sólo existe la barrera de Schottky, es una
línea recta, como lo muestra la figura 3,
aunque para algunos otros propósitos las curvas que
se presentan son simplemente C-V, como por ejemplo
las que presentan Prokhorov,
et al.
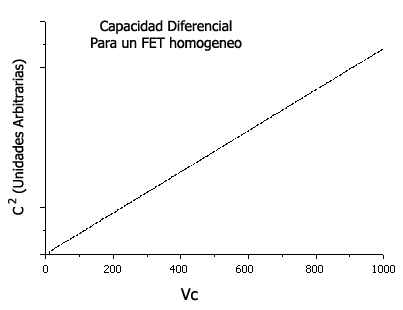
Figura
3. Capacitancia diferencial en un FET
Transistores
Efecto de Campo con Dopaje Tipo Delta
Este
tipo de dispositivos semiconductores, a diferencia de los
presentados anteriormente, tienen la ventaja de que pueden
ser utilizados en aplicaciones que requieren altas velocidades
de respuesta, porque la implementación de un dopaje
tipo delta produce un confinamiento electrónico en
un plano paralelo a la dirección de la corriente,
lo que se ve reflejado en la mayor movilidad de portadores
de carga a lo largo del canal de conducción, característica
que exigen los dispositivos electrónicos de alta
frecuencia.
Lo
primero que debemos mencionar es la técnica de crecimiento
que permite construir este tipo de dispositivos y estructuras
mucho más complicados. Estamos hablando de la ya
muy conocida epitaxia de haces moleculares (MBE por sus
siglas en inglés).
Esta
técnica de crecimiento tiene la característica
principal de hacer crecer muestras semiconductoras, capa
atómica por capa atómica. De esta manera,
es posible dopar fuertemente de impurezas unas cuantas capas
atómicas. En el límite en que tenemos una
sola capa atómica fuertemente dopada, decimos que
tenemos un pozo cuántico delta-dopado. Este es precisamente
el perfil de dopaje que se utiliza en la construcción
de los transistores efecto de campo que estamos estudiando.
En la figura 4 mostramos un módulo de crecimiento
MBE

Figura
4. Módulo MBE
Los
Sistemas
Describiremos
de manera muy sencilla cómo se construyen los d-FET
y los ALD-FET (Atomic Layer Doped-FET). Sobre
un substrato semiconductor ligeramente impurificado tipo
p se difunden dos regiones homogéneas fuertemente
dopadas de impurezas tipo n. Estas regiones actúan
como terminales de entrada y salida de portadores mayoritarios.
Dichas terminales son fuente y drenaje, respectivamente.
Entre estas dos regiones se deposita una cierta aleación
metálica, que junto con el semiconductor generan
la barrera de Schottky. Esta terminal recibe el nombre de
compuerta. Esta es la manera como se construye un FET con
densidad homogénea de impurezas, cuyo caso es el
antes mencionado.
Pero
supongamos ahora que entre las terminales fuente y drenaje
crece una capa atómica fuertemente dopada de impurezas
tipo n , y además una tipo p en el
caso del ALD-FET. Al hecho de dopar fuertemente de
impurezas una sola capa atómica, se denomina dopaje
tipo delta. La densidad de impurezas se describe teóricamente
mediante una función delta de Dirac, es decir, obtenemos
un d-FET (figura 5)
o un ALD-FET en el caso de tener también el
pozo delta dopado de tipo p.
En
principio, podría pensarse que este par de sistemas
son sólo una variedad de los H-FET, en los
que el canal está formado por una heteroestructura,
pero los pozos delta dopados no son heteroestructuras. Lo
único que tienen en común estos dos sistemas
es la existencia de gases electrónicos que están
confinados en un plano, pero incluso esta propiedad no es
aplicable en todo el intervalo de parámetros de trabajo
experimental.
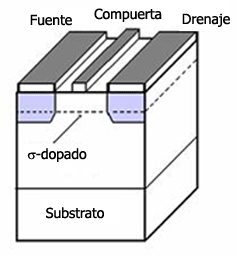
Figura
5. Construcción de un d-FET
en una matriz de GaAs.
Modelos
A
continuación presentamos los modelos matemáticos
que nos permiten modelar las principales características
electrónicas de los transistores efecto de campo
que estamos estudiando:
En
1995 L. M. Gaggero Sager y R. Pérez Álvarez
propusieron un modelo para describir la banda de conducción
del semiconductor en los d-FET,
el cual se expresa matemáticamente de la siguiente
manera (Gaggero y
Pérez, 1995):

(Ecuación
3)
lp es la posición para la cual
el potencial se anula (corresponde al ancho de la región
de empobrecimiento); d es la distancia a la que se
coloca el pozo delta dopado tipo n; l es la longitud
de Debye; er
es la constante dieléctrica del GaAs; Nd
es la concentración de impurezas de background y
e la carga electrónica. l está
dada por:

(Ecuación
4)
En
este modelo Vn(z) es una expresión
propuesta por Ioriatti en 1990, que reproduce las propiedades
electrónicas de los pozos delta dopados (Ioriatti,
1990).

(Ecuación
5)
Aquí
a=2/15p
y zo=(a3/N2dp)1/5,
donde N2d es la densidad bidimensional
de impurezas del pozo delta dopado. Los valores de las densidades
usadas, son: N2de=2.5, 5.0, 7.5 x
1012 cm-2 y
N2de=2.5, 5.0, 7.5 x 1011
cm-2. La densidad más alta
corresponde al pozo más profundo.
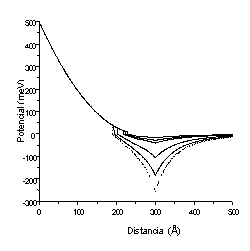
Figura
6. Gráfica de potencia para un d-FET
en GaAs
En
el caso del ALD-FET el modelo propuesto es muy similar
al anterior, sólo que ahora debemos considerar el
potencial debido al pozo delta dopado, del tipo p
que forma parte de este dispositivo, es decir (Martínez
y Gaggero, 2001):

(Ecuación
6)
La
expresión para el pozo delta dopado tipo p
es:

(Ecuaciones
7 y 8)
donde
mlh es la masa de los huecos
ligeros;mhh
es la masa de los huecos pesados;dp
es la posición en la que se encuentra el pozo delta
tipo p, y por último zop
es igual a:

(Ecuación
9)
Los
valores para los parámetros utilizados en los cálculos,
son los siguientes:Nd=1x1018cm-3,
er= 12.5,
mlh = 0.087m0.
mhh =0.52m0,
donde m0 es la masa del electrón
en reposo. El pozo delta dopado tipo n está
situado a 300 Å de la interfase y el pozo tipo
p, a 500 Å.
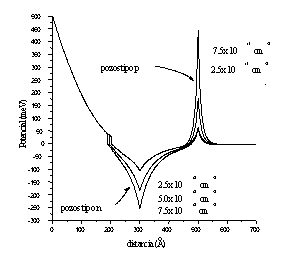
Figura
7. Perfil del potencial para un ALD-FET. Los valores
para la densidad bidimensional de impurezas de los pozos
tipo n y p están dados en la gráfica. Esta
gráfica de la banda de conducción está
dada para un voltaje de contacto Vc=
500 meV.
Todas
estas expresiones están dadas en unidades del Rydberg
efectivo (5.83 meV) y del radio de Bohr efectivo (9.87 nm).
La
ventaja de tener un pozo delta dopado adicional tipo p
en el ALD-FET, en comparación con el d-FET,
es que éste confina aún más los electrones
y por lo tanto contribuyen más a la movilidad del
dispositivo, además de que el propio pozo tipo p
incrementa la conducción. Es decir, en el caso del
ALD-FET se tiene mucha más movilidad que en el
caso del d-FET. En la actualidad
existen transistores efecto de campo con múltiples
pozos delta dopados (Ming,
et al. 1996)14,
pero por el momento nos concentramos en calcular las características
electrónicas de estos dos dispositivos.
Resultados
A
continuación mostramos los resultados obtenidos para
los cálculos de la capacitancia diferencial. En otras
palabras, calculamos numéricamente cómo varía
el ancho de la región de empobrecimiento con el voltaje
de contacto (ver ecuación 2). Cabe mencionar que
presentaremos curvas de capacitancia diferencial a la menos
dos contra el voltaje de contacto, y no simplemente de capacitancia
contra voltaje. La razón de esto es que el análisis
de las pendientes de dichas curvas, permite determinar características
como la densidad de impurezas, el alto de la barrera de
Schottky, etcétera, como ya se mencionó en
la introducción. Por ejemplo, en el caso de un transistor
efecto de campo con densidad de impurezas homogéneas,
las curvas de C-2 contra Vc
presentan un comportamiento lineal, como lo muestra la figura
3. Al medir la pendiente de dicha recta, se obtiene
la densidad de impurezas del semiconductor multiplicado
por una constante. En la actualidad esto se hace automáticamente,
con la ayuda de instrumentos de medición de capacitancia
diferencial contra voltaje y corriente contra voltaje, pero
nuestras conclusiones ponen de manifiesto que debemos tener
cuidado en la manera como se tratan los resultados experimentales.
Si se trazara la mejor línea recta con las curvas
que a continuación presentamos, entonces la pendiente
de ésta corresponderá a una densidad de impurezas
que en realidad no posee el dispositivo que tratamos de
caracterizar, puesto que en nuestro caso este es un parámetro
de entrada de nuestro cálculo teórico. Por
lo tanto, proponemos que en lugar de ajustar los datos experimentales
a una recta en este tipo de dispositivos, deben de ajustarse
a alguna de las curvas (la que ajuste mejor) y con los modelos
presentados anteriormente, investigar los parámetros
que nos interesan. En pocas palabras, al utilizar esta técnica
en transistores de efecto de campo con dopaje deltaico,
es necesario analizar con mayor cuidado los resultados obtenidos,
puesto que, en general, no deben dar una línea recta.
La esencia de la cuestión es que en estos sistemas,
el ancho de la región de empobrecimiento no depende
de manera trivial del potencial de contacto.
La
figura 8 presenta las curvas obtenidas para la capacitancia
diferencial a la menos dos contra el voltaje de contacto,
esto, para un transistor efecto de campo con dopaje tipo
delta (d-FET) en una matriz de
GaAs. Los valores usados en este cálculo aparecen
en la gráfica. Se comparan estas curvas con la que
se obtendría si no existiera pozo delta dopado (la
recta que corresponde a la curva situada más abajo).
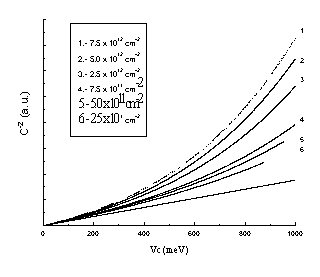
Figura
8. Gráfica de capacitancia diferencial para
un d-FET.
Por
último, en la figura 9 están las curvas obtenidas
para la capacitancia diferencial a la menos dos, cuando
analizamos el transistor efecto de campo con dopaje en capas
atómicas (ALD-FET). Nuevamente aquí,
al igual que en la gráfica anterior, los valores
de las densidades de impurezas de los pozos delta dopados
tipo n, están en la figura y tomamos un valor
fijo de la densidad de impurezas del tipo p igual
a N2dp = 7.5x1012
cm-2
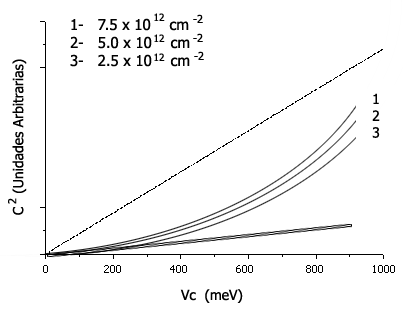
Figura
9. Gráfica de capacitancia diferencial para
un ALD-FET.
Conclusiones
A
simple vista es posible observar (figuras 8 y 9)
que los dos dispositivos estudiados en este artículo
(d-FET y ALD-FET),
tienen comportamientos cualitativos similares en cuanto
a la capacitancia diferencial se refiere. Evidentemente,
en el caso del ALD-FET el confinamiento electrónico
será mayor que en el d-FET.
Como además en el dispositivo ALD-FET la conducción
es de huecos y electrones, para un mismo valor del voltaje,
debe haber una mayor corriente. Sin embargo, el d-FET
resulta más fácil de construir que el ALD-FET.
Esto sucede por varias razones: Primero, los efectos de
difusión de impurezas pueden destruir el sistema.
Las impurezas tipo n y tipo p pueden difundirse
de tal manera que no se formen dos pozos cuánticos,
sino una juntura p-n. Segundo, porque en caso de
tener ambos pozos, la distancia entre ellos debe ser tal
que la interacción coulombiana entre ambos gases
de partículas cargadas con signos opuestos, sea mínima.
Esta situación podría llevar a que el ALD-FET
tuviera una movilidad menor que el de un FET con
densidad de impurezas homogéneas (FET tradicional).
Finalmente,
al observar las figuras 8 y 9, resulta claro
que la presencia de pozos cuánticos delta-dopados
lleva consigo una pérdida de la linealidad de las
curvas C-V. Por lo tanto, al realizar estas mediciones
en estos sistemas, debe tenerse mucho cuidado a la hora
de analizar los resultados. Un análisis detallado
requeriría de cálculos autoconsistentes completos.
Es posible, sin perder demasiada precisión, realizar
este análisis, utilizando los modelos propuestos
en este artículo. En general, la utilización
de esta técnica de caracterización de dispositivos
semiconductores no es trivial. Como sucede con casi todas
las técnicas modernas, requiere verdaderamente mucho
talento. Existen problemas adicionales que no hemos discutido
por simplicidad, pero resulta evidente que no puede seguirse
lo señalado en los libros de texto, en estos tipos
de transistores de efecto de campo. Aunque esta técnica
experimental presenta sus dificultades, tiene como principal
ventaja, en comparación con las técnicas ópticas,
el ser mucho más económica.
|